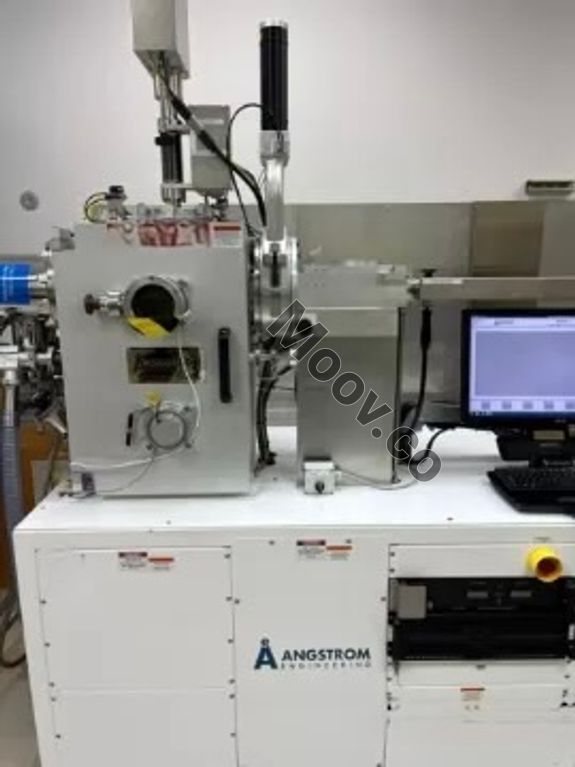
説明
Nexdep Base System with Advanced PC/PLC Automation Frame and Baseplate • Universal Nexdep 16in × 16in base flange • Built on a powder coated solid welded steel enclosure Vacuum Chamber • 16inW × 16inD × 20inH: aluminum high vacuum box chamber • Glass bead blast finish on chamber surfaces • Two set removable stainless steel debris shields • Hinged chamber front door for easy internal access • Base pressure of <5×10-7 Torr in a clean system • Large viewport offset to reduce material deposition System Control • PC control station with Windows 7 Professional • Windows Based SCADA - PLC control interface software • Auto-sequence and manual mode system control • System operation safety interlock status & alerts • Various user account program security authorizations • Light tower provides system status • Evaluated to meet NEC 2011 (NFPA 70) and EN 61010 by an OSHA approved NRTL Manual Load Lock with Rough Vacuum Pumping • Load lock vacuum chamber • Quick access port on one location • Isolated from chamber by a pneumatic gate valve • Achieves low vacuum by sharing system rough pump • Includes transfer arm and one "parking location" Load Lock High Vacuum Pumping • Pfeiffer Hi-Pace 80 • Air cooled 67 l/s turbo pump Cryogenic Pumping Package • CTI Cryo-Torr 8/8F high vacuum pump • Model 9600 helium compressor will be supplied by user • 10ft helium lines • Isolated using a VAT gate valve • Automatic pumping, venting and regeneration • Base pressure of <9×10-8 Torr in a clean & dry system • Heated N2 purge for faster regeneration Rough Pump Integration Package • Allows a user specified rough pump to be integrated to the system Angstrom Sciences Onyx-3 (3in) Circular Sputter Source • Secure flexible head design • Threaded target clamp for quick target changes • Uniform cooling provided by turbulent flow design • Advanced high strength NdFeB magnet array • Solid magnet assembly for high material utilization • Computer modeled for optimized film uniformity 1.2kW DC Sputter Power Supply • Higher sustained voltage allows breakthru on oxides & contaminants • Ripple less than 0.02% of rated voltage at full load • Self protection from arc, over-voltage & over-current Switch for Sputter Power Supply • Allows DC power supply to be shared between each of the 3 sputter sources Nexdep Advanced Downstream Gas Pressure Control • Recipe based software controlled pressure stabilization • 2 MKS M100B 20sccm mass flow controllers provide precise gas mixing • Inficon SKY capacitance diaphragm process gauge (1-100mTorr) • VAT throttling butterfly valve PC Based Deposition Rate and Film Thickness Control • PC Windows based software for deposition control • Allows easy recipe creation, storage and editing • Film setup parameters and deposition data are saved to computer hard disk • Allows sequential and co-deposition films to be deposited with fully automated recipe control QCM Deposition Rate Sensor • Sensor is mounted to a rigid bracket to prevent lossof calibration if accidently moved • Sensor is water cooled to improve reading accuracy Rotating Substrate Stage • Sample holder designed to mount a Ø150mm substrate or smaller pieces • Custom sample holders available upon request • Source to substrate distance varies with configuration • 0-50 RPM continuous rotation capability • Includes a dedicated MFC and gas delivery to the substrate surface Backside Quartz Lamp IR Substrate Heating • Temperature control from ambient to 250°C • Multi-stage heat shield design for increased efficiency • PID based temperature control using a non-contact reference thermocouple • Other temperature ranges are available Source Shutter • Automatic process controlled pneumatic shutter • Uses a high quality magnetic fluid rotary feedthrough Split 2-Piece Substrate Shutter • Automatic process controlled pneumatic shutters • Uses high quality magnetic fluid rotary feedthroughs構成
Sputter Deposition Can Accommodate 3 TargetsOEMモデルの説明
Nexdep physical vapor deposition platform can accommodate up to 6 sources, a wide variety of PVD processes, and can be outfitted to achieve ultra-high vacuum (UHV).ドキュメント
ドキュメントなし
カテゴリ
PVD / Sputtering
最終検証: 30日以上前
主なアイテムの詳細
状態:
Used
稼働ステータス:
不明
製品ID:
134521
ウェーハサイズ:
不明
ヴィンテージ:
2016
Logistics Support
Available
Transaction Insured by Moov
Available
Refurbishment Services
Available
ANGSTROM ENGINEERING
NEXDEP
カテゴリ
PVD / Sputtering
最終検証: 30日以上前
主なアイテムの詳細
状態:
Used
稼働ステータス:
不明
製品ID:
134521
ウェーハサイズ:
不明
ヴィンテージ:
2016
Logistics Support
Available
Transaction Insured by Moov
Available
Refurbishment Services
Available
説明
Nexdep Base System with Advanced PC/PLC Automation Frame and Baseplate • Universal Nexdep 16in × 16in base flange • Built on a powder coated solid welded steel enclosure Vacuum Chamber • 16inW × 16inD × 20inH: aluminum high vacuum box chamber • Glass bead blast finish on chamber surfaces • Two set removable stainless steel debris shields • Hinged chamber front door for easy internal access • Base pressure of <5×10-7 Torr in a clean system • Large viewport offset to reduce material deposition System Control • PC control station with Windows 7 Professional • Windows Based SCADA - PLC control interface software • Auto-sequence and manual mode system control • System operation safety interlock status & alerts • Various user account program security authorizations • Light tower provides system status • Evaluated to meet NEC 2011 (NFPA 70) and EN 61010 by an OSHA approved NRTL Manual Load Lock with Rough Vacuum Pumping • Load lock vacuum chamber • Quick access port on one location • Isolated from chamber by a pneumatic gate valve • Achieves low vacuum by sharing system rough pump • Includes transfer arm and one "parking location" Load Lock High Vacuum Pumping • Pfeiffer Hi-Pace 80 • Air cooled 67 l/s turbo pump Cryogenic Pumping Package • CTI Cryo-Torr 8/8F high vacuum pump • Model 9600 helium compressor will be supplied by user • 10ft helium lines • Isolated using a VAT gate valve • Automatic pumping, venting and regeneration • Base pressure of <9×10-8 Torr in a clean & dry system • Heated N2 purge for faster regeneration Rough Pump Integration Package • Allows a user specified rough pump to be integrated to the system Angstrom Sciences Onyx-3 (3in) Circular Sputter Source • Secure flexible head design • Threaded target clamp for quick target changes • Uniform cooling provided by turbulent flow design • Advanced high strength NdFeB magnet array • Solid magnet assembly for high material utilization • Computer modeled for optimized film uniformity 1.2kW DC Sputter Power Supply • Higher sustained voltage allows breakthru on oxides & contaminants • Ripple less than 0.02% of rated voltage at full load • Self protection from arc, over-voltage & over-current Switch for Sputter Power Supply • Allows DC power supply to be shared between each of the 3 sputter sources Nexdep Advanced Downstream Gas Pressure Control • Recipe based software controlled pressure stabilization • 2 MKS M100B 20sccm mass flow controllers provide precise gas mixing • Inficon SKY capacitance diaphragm process gauge (1-100mTorr) • VAT throttling butterfly valve PC Based Deposition Rate and Film Thickness Control • PC Windows based software for deposition control • Allows easy recipe creation, storage and editing • Film setup parameters and deposition data are saved to computer hard disk • Allows sequential and co-deposition films to be deposited with fully automated recipe control QCM Deposition Rate Sensor • Sensor is mounted to a rigid bracket to prevent lossof calibration if accidently moved • Sensor is water cooled to improve reading accuracy Rotating Substrate Stage • Sample holder designed to mount a Ø150mm substrate or smaller pieces • Custom sample holders available upon request • Source to substrate distance varies with configuration • 0-50 RPM continuous rotation capability • Includes a dedicated MFC and gas delivery to the substrate surface Backside Quartz Lamp IR Substrate Heating • Temperature control from ambient to 250°C • Multi-stage heat shield design for increased efficiency • PID based temperature control using a non-contact reference thermocouple • Other temperature ranges are available Source Shutter • Automatic process controlled pneumatic shutter • Uses a high quality magnetic fluid rotary feedthrough Split 2-Piece Substrate Shutter • Automatic process controlled pneumatic shutters • Uses high quality magnetic fluid rotary feedthroughs構成
Sputter Deposition Can Accommodate 3 TargetsOEMモデルの説明
Nexdep physical vapor deposition platform can accommodate up to 6 sources, a wide variety of PVD processes, and can be outfitted to achieve ultra-high vacuum (UHV).ドキュメント
ドキュメントなし